Flash 闪存颗粒和工艺知识深度解析
Wafer 即晶圆,是半导体组件“晶片”或“芯片”的基材,从沙子里面高温拉伸生长出来的高纯度硅晶体柱 (Crystal Ingot)上切下来的圆形薄片称为“晶圆”。采用精密“光罩”通过感光制程得到所需的“光阻”,再对硅材进行精密的蚀刻凹槽,继续以金属真空蒸着制程,于是在各自独立的“晶粒”(Die)上完成其各种微型组件及微细线路。对晶圆背面则还需另行蒸着上黄金层,以做为晶粒固着 (Die Attach) 于脚架上的用途。
以上流程称为 Wafer Fabrication。早期在小集成电路时代,每一个 6 吋的晶圆上制作数以千计的晶粒,现在次微米线宽的大型 VLSI,每一个 8 吋的晶圆上也只能完成一两百个大型芯片。我们 NAND Flash 的 Wafer,目前主要采用 8 寸和 12 寸晶圆,一片晶圆上也只能做出一两百颗 NAND Flash 芯片来。
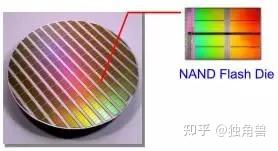
(图片来自于网络)
Wafer 的制造虽动辄投资数百亿,但却是所有电子工业的基础。晶圆的原始材料是硅,而地壳表面有用之不竭的二氧化硅。二氧化硅矿石经由电弧炉提炼,盐酸氯化,并经蒸馏后,制成了高纯度的多晶硅,其纯度高达 99.99% 以上。晶圆制造厂再将此多晶硅融解,再在融液里种入籽晶,然后将其慢慢拉出,以形成圆柱状的单晶硅晶棒,由于硅晶棒是由一颗晶面取向确定的籽晶在熔融态的硅原料中逐渐生成,此过程称为“长晶”。硅晶棒再经过切段,滚磨,切片,倒角,抛光,激光刻,封装后,即成为集成电路工厂的基本原料——硅晶圆片,这就是“晶圆”。
下图是 NAND Flash 生产简要流程:
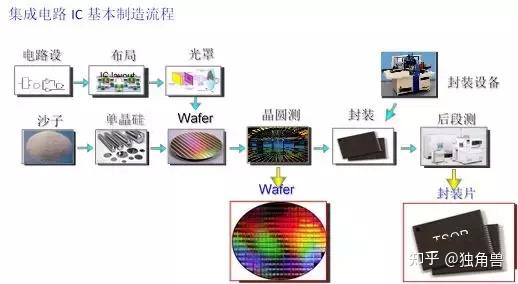
(图片来自于网络)
Die 就是芯片未封装前的晶粒,是从硅晶圆 (Wafer) 上用激光切割而成的小片 (Die)。每一个 Die 就是一个独立的功能芯片,它无数个晶体管电路组成,但最终将被作为一个单位而被封装起来成为我们常见的闪存颗粒,CPU 等常见芯片。
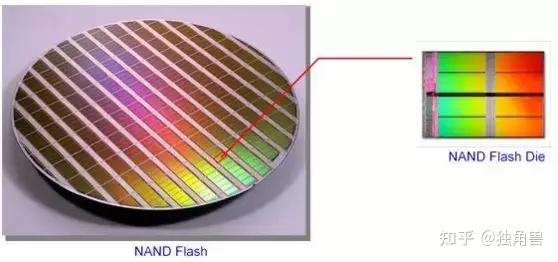
(图片来自于网络)
什么是 ink Die
在晶圆制造过程中,会对 Wafer 中的每个 Die 进行严格测试,通过测试的 Die,就是 Good Die,未通过测试的即为 Ink Die。这个测试过程完成后,会出一张 Mapping 图,在 Mapping 里面会用颜色标记出不良的 Die,故称 Ink Die。

(图片来自于网络)
Flash 芯片封装分类
目前 NAND Flash 封装方式多采取 TSOP、FBGA 与 LGA 等方式,由于受到终端电子产品转向轻薄短小的趋势影响,因而缩小体积与低成本的封装方式成为 NAND Flash 封装发展的主流趋势。
**TSOP: (Thin smaller outline package)**封装技术,为目前最广泛使用于 NAND Flash 的封装技术,首先先在芯片的周围做出引脚,采用 SMT 技术(表面安装技术)直接附着在 PCB 板的表面。TSOP 封装时,寄生参数减小,因而适合高频的相关应用,操作方便,可靠性与成品率高,同时具有价格便宜等优点,因此于目前得到了极为广泛的应用。
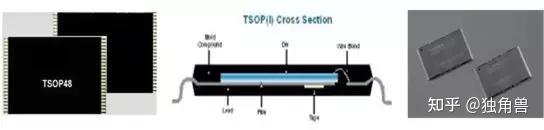
(图片来自于网络)
BGA: (Ball Grid Array 也称为锡球数组封装或锡脚封装体) 封装方式,主要应用于计算机的内存、主机板芯片组等大规模集成电路的封装领域,FBGA 封装技术的特点在于虽然导线数增多,但导线间距并不小,因而提升了组装良率,虽然功率增加,但 FBGA 能够大幅改善电热性能,使重量减少,信号传输顺利,提升了可靠性。
采用 FBGA 新技术封装的内存,可以使所有计算机中的内存在体积不变的情况下容量提升数倍,与 TSOP 相比,具有更小的体积与更好的散热性能,FBGA 封装技术使每平方英寸的储存量有很大的提升,体积却只有 TSOP 封装的三分之一,与传统 TSOP 封装模式相比,FBGA 封装方式有加快传输速度并提供有效的散热途径,FBGA 封装除了具备极佳的电气性能与散热效果外,也提供内存极佳的稳定性与更多未来应用的扩充性。
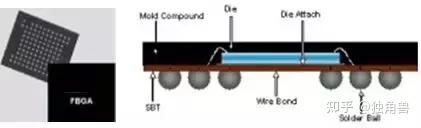
(图片来自于网络)
LGA: (Land Grid Array) 触点陈列封装,亦即在底面制作有数组状态坦电极触点的封装,装配时插入插座即可,现有 227 触点 (1.27mm 中心距) 和 447 触点 (2.54mm 中心距) 的陶瓷 LGA,应用于高速逻辑 LSI 电路,由于引线的阻电抗小,对高速 LSI 相当适用的,但由于插座制作复杂,成本较高,普及率较低,但未来需求可望逐渐增加。

(图片来自于网络)
Flash 芯片封装叠 Die(Stack Die)
由于 NAND Flash 单颗 Die 的容量有限,为了实现更高的容量,需要在一个封装片内堆叠几个 Die。在 Wire Bond 的时候,用金线互连。
目前单颗 Die 的容量最高的为 Micron 公司的 MLC 4GB,目前最先进的堆叠技术可以叠 8 层,因此理论上 MLC 单颗封装片可以做到 32GB。Micron 公司计划在 09 年 Q4 推出此容量的封装片。
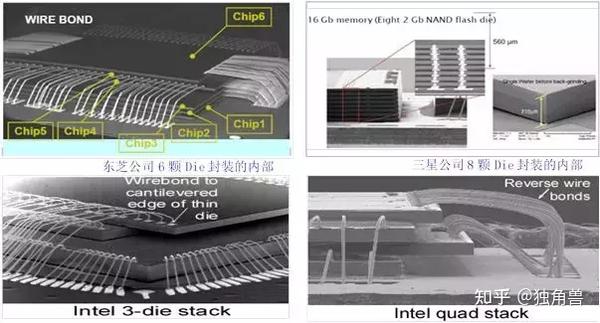
(图片来自于网络)
Flash 芯片 TSOP 封装和 BGA 封装的内部结构
TSOP 封装只需要一个引脚框架,把 NAND FLASH Die 的 Pad 打线 (Wire Bond) 连接到引进框架上面即可。封装技术简单,成本低。但其打线方式只能从两边打线,因此 stack die 就比较困难。
BGA 封装与 TSOP 封装不同在于其采用了 Substrate,用电路板来对引脚走线,因此可以进行四面打线,这样在进行叠 die 的时候,就变得更加容易操作。但成本会比 TSOP 要高。
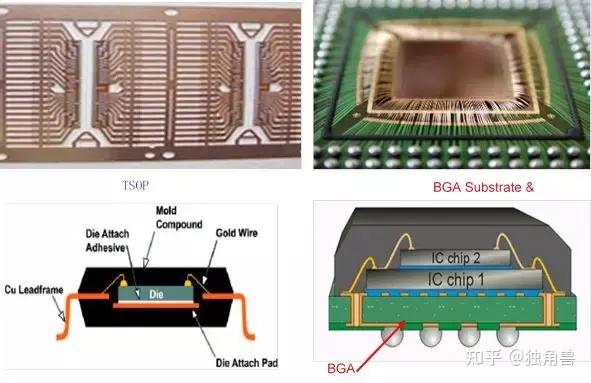
(图片来自于网络)
Flash 芯片封装的尺寸,一些封装方式尺寸比较:
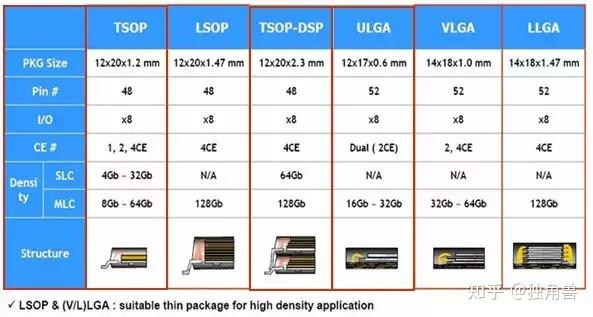
(图片来自于网络)
NAND Flash 出货有两种产品样式:
一种是 Wafer,即晶圆出货,这种产品样式一般客户采购回去需要再测试和 COB 封装等,这种客户多为闪存卡大客户。
一种是封装片出货,NAND Flash 目前最普遍采用的是 48TSOP1 的封装方式,现货市场均为 TSOP 的封装片。
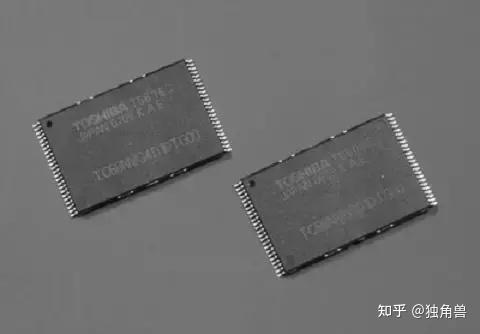
(图片来自于网络)
NAND Flash 按工艺可分为 SLC 与 MLC
SLC 英文全称 (Single Level Cell) 即单层式单元储存。SLC 技术特点是在浮置闸极与源极之中的氧化薄膜更薄,在写入数据时通过对浮置闸极的电荷加电压,然后透过源极,即可将所储存的电荷消除,通过这样的方式,便可储存 1 个信息单元,这种技术能提供快速的程序编程与读取,不过此技术受限于 Silicon efficiency 的问题,必须要用较先进的流程强化技术,才能向上提升 SLC 制程技术。
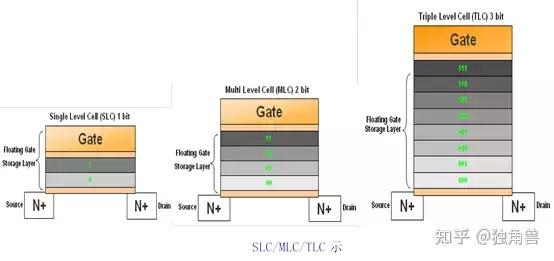
(图片来自于网络)
MLC 英文全称 (Multi Level Cell) 即多层式单元储存。Intel 在 1997 年 9 月最先开发成功 MLC,其作用是将两个单位的信息存入一个 Floating Gate(闪存存储单元中存放电荷的部分),然后利用不同电位 (Level) 的电荷,通过内存储存的电压控制精准读写。MLC 通过使用大量的电压等级,每一个单元储存两位数据,数据密度比较大。SLC 架构是 0 和 1 两个值,而 MLC 架构可以一次储存 4 个以上的值。因此,MLC 架构可以有比较高的储存密度。
TLC 英文全称 (Triple Level Cell) 即一个单元可以存储单元可以存储 3bit,因此需要 8 个等级的电位进行编码解码才能实现。其实 TLC 是属于 MLC 的一种。
SLC 和 MLC 的基本特性表
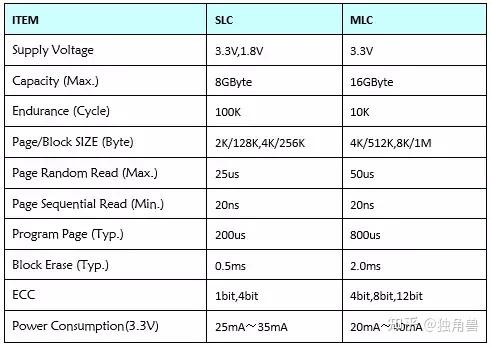
(图片来自于网络)
Flash 坏块的形成
NAND Flash 的存储原理是,在写入 (Program) 的时候利用 F-N 隧道效应 (Tunnel Injection 隧道注入) 的方法使浮栅充电,即注入电荷;在擦除 (Erase) 的时候也是是利用 F-N 隧道效应 (Tunnel Release 隧道释放) 将浮栅上的电荷释放。
隧道注入和隧道释放的产生都需要十几伏的瞬间高电压条件,这对浮栅上下的氧化层会造成一定损伤,因此这样重复的操作 (P/E Cycle) 是有限的。SLC 大概是 100K 次,MLC 大概是 10K 次。达到读写寿命极限的时候存储单元就会出现失效,然后就会造成数据块擦除失效,以及写入失效,于是就会被标记起来,作为坏块,并将这个标记信息存放在 Spare Area 里面,后续操作这个 Block 时,需要 Check 一下这个信息。
Flash 固有坏块
由于制造工艺的原因,通常普通的 NAND FLASH 从出厂开始就有坏块了,一般在 2‰以下。一般芯片原厂都会在出厂时都会将坏块第一个 page 的 spare area 的第 6 个 byte 标记为不等于 0xff 的值。
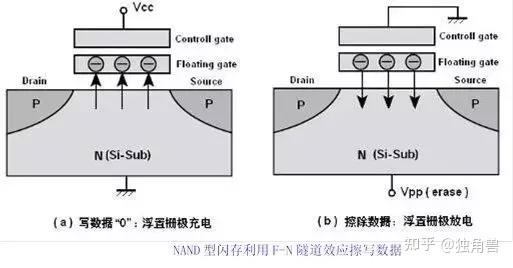
(图片来自于网络)
NAND Flash 的存储单元是有使用寿命的
NAND Flash 的存储原理是,在写入 (Program) 的时候利用 F-N 隧道效应 (Tunnel Injection 隧道注入) 的方法使浮栅充电,即注入电荷;在擦除 (Erase) 的时候也是是利用 F-N 隧道效应 (Tunnel Release 隧道释放) 将浮栅上的电荷释放。隧道注入和隧道释放的产生都需要 20V 左右瞬间高电压条件,这对浮栅上下的氧化层会造成一定损伤,因此这样重复的操作 (P/E Cycle) 是有限的。SLC 大概是 100K 次,MLC 大概是 10K 次。
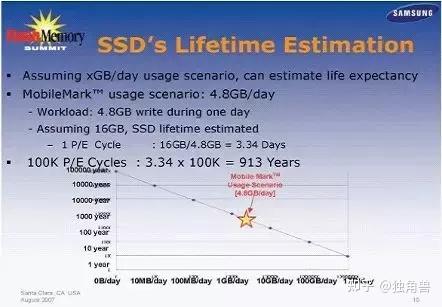
(图片来自于网络)
如果每天对 SSD 写入 4.8GB 的数据,假设 SSD 总容量为 16GB,那么,你至少需要 3.34 天才能对整个 SSD 的每个单元擦写一次;如果此 SSD 为擦写次数为 100K 的 SLC 单元,那么,你至少需要 3.34×100K 天才能使这个 SSD 完全失效;3.34×100K 天=913 年,因此 16G 的 SSD 可以使用 913 年。那么,如果是 MLC 的话,也至少可以使用 91.3 年。
晶圆制程工艺发展历史
芯片制程工艺是指晶圆内部晶体管之间的连线间距。按技术述语来说,也就是指芯片上最基本功能单元门电路和门电路间连线的宽度。
主流厂商的晶圆制程工艺以及下一代制程工艺的情况,如下表。
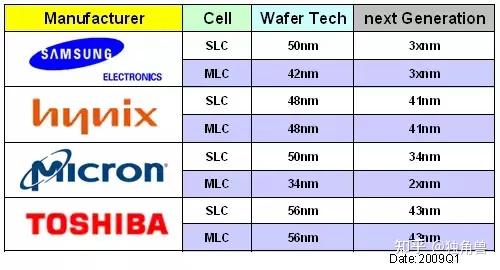
(图片来自于网络)
芯片制造工艺在 1995 年以后,从 0.5 微米、0.35 微米、0.25 微米、0.18 微米、0.15 微米、0.13 微米、90 纳米、75 纳米、65 纳米一直发展到目前最新的 34 纳米。
一步步印证了摩尔定律的神奇。以 90 纳米制造工艺为例,此时门电路间的连线宽度为 90 纳米。我们知道,1 微米相当于 1/60 头发丝大小,经过计算我们可以算出,0.045 微米 (45 纳米) 相当于 1/1333 头发丝大小。可别小看这 1/1333 头发丝大小,这微小的连线宽度决定了芯片的实际性能,芯片生产厂商为此不遗余力地减小晶体管间的连线宽度,以提高在单位面积上所集成的晶体管数量。采用 34 纳米制造工艺之后,与 65 纳米工艺相比,绝对不是简单地令连线宽度减少了 31 纳米,而是芯片制造工艺上的一个质的飞跃。
目前最先实现 34nm 工艺的是 Intel 和 Micron 联合投资的 IM,此技术被最先应用在了 NAND FLASH 上面,可见 NAND FLASH 的制程工艺跳跃是所有 IC 中最快的。
晶圆技术的发展都是受生产力驱动,必须向更小的制程间距和更大的晶圆尺寸发展。制程从 2.0um、0.5um、0.18um、90nm 一直到目前的 34nm,晶圆尺寸从最初的 5 英寸发展到目前的 12 英寸,每次更迭都是一次巨大的技术跳跃,凝聚了人类科技的结晶,也一次次印证了摩尔定律的神奇。

(图片来自于网络)
晶圆尺寸的大约每 9 年切换一次。而晶圆制程由最初的几年更迭一次,到目前的基本上每年都能更迭一次。
DDR4颗粒位宽还分4位和8位吗? - 知乎 (zhihu.com)
内存条颗粒分为 4 位位宽 8 位位宽 16 位位宽,也就是 X4、X8 和 X16,一般 X4 是服务器用的,X8 是我们最常用的,X16 的较少
X4 和 X8 是指内存颗粒的规格,一般 PC 和笔记本内存都是 X 8,服务器内存会用 X4 的多些,不过现在很多服务器内存也开始用 X8 位的颗粒,同样容量, X 8 颗粒的价格一般会便宜些!
单面内存和双面内存主要是说内存条是说一面有颗粒的内存和两面都贴满颗粒的内存,它和内存的容量有关系,也和内存规格有一定联系!
按正常情况,现在的内存颗粒容量大了,如果做成以前内存的容量,肯定都是单面的,不过现在内存条容量也越做越大,所以现在内存反倒是双面的多!
什么是单面内存和双面内存?——————
单面内存指内存颗粒都集成在内存条一面上,双面内存指内存颗粒分布在内存条两面上。单、双面内存它们的本身没有好坏,区别也很小,具体介绍如下:
1、单面内存和双面内存在电气性能上没有什么区别,单双就是指内存的 PCB 板上是一面有颗粒还是两面都有,单个颗粒如果都是 64MB,单面就是 64*8=512MB,双面就是 1024MB 了,所以双面内存相对来说容易增大容量。
2、从生产工艺的角度来说,生产单面内存也比双面内存简单一些,所以现在市场上看到的内存多以单面产品为主。 同等容量的内存,单面比双面的集成度要高,生产日期要靠后,所以工作起来就更稳定。
3、相同容量的内存,建议买单面内存,因为单面的制作的水平比较高,而且单面内存只占用一个 BANK,有的主板只能支持 4 个 BANK,4 根插槽如果用 2 根双面内存就占满了,其他两个槽可能用不了。


扩展资料
评价内存条的性能指标一共有四个:
(1) 存储容量:即一根内存条可以容纳的二进制信息量,如常用的 168 线内存条的存储容量一般多为 32 兆、64 兆和 128 兆。而 DDRII3 普遍为 1GB 到 8GB。
(2) 存取速度(存储周期):即两次独立的存取操作之间所需的最短时间,又称为存储周期,半导体存储器的存取周期一般为 60 纳秒至 100 纳秒。
(3) 存储器的可靠性:存储器的可靠性用平均故障间隔时间来衡量,可以理解为两次故障之间的平均时间间隔。
(4) 性能价格比:性能主要包括存储器容量、存储周期和可靠性三项内容,性能价格比是一个综合性指标,对于不同的存储器有不同的要求。
2019-09-18
内存条 8 个颗粒和 4 个颗料之间的区别?—————
内存条上的颗粒就是存储芯片,如 256M 单面有 8 个的话,那么一个芯片的容量就是 256/8,如果是双面的一个芯片的容量就是 256/16,同样大小内存,8 个颗粒说明每个颗粒的容量是 4 个颗粒的一半。如果你用两根内存,就要用一样的。
内存颗粒简介—————
晶圆,一般有 6 英寸、8 英寸及 12 英寸规格不等,晶片就是基于晶圆生产出来的。晶圆上一个小块,一个小块,就是晶片晶圆体,也名 Die,经过封装之后就成为一个闪存颗粒。

1、颗粒容量
例:samsungk4h280838b-tcb0
主要含义:
第 1 位——芯片功能 k,代表是内存芯片。
第 2 位——芯片类型 4,代表 dram。
第 3 位——芯片的更进一步的类型说明,s 代表 sdram、h 代表 ddr、g 代表 sgram。
第 4、5 位——容量和刷新速率,容量相同的内存采用不同的刷新速率,也会使用不同的编号。64、62、63、65、66、67、6a 代表 64mbit 的容量;28、27、2a 代表 128mbit 的容量;56、55、57、5a 代表 256mbit 的容量;51 代表 512mbit 的容量。
第 6、7 位——数据线引脚个数,08 代表 8 位数据;16 代表 16 位数据;32 代表 32 位数据;64 代表 64 位数据。
第 11 位——连线“-”。
第 14、15 位——芯片的速率,如 60 为 6ns;70 为 7ns;7b 为 7.5ns(cl=3);7c 为 7.5ns(cl=2);80 为 8ns;10 为 10ns(66mhz)。
2、鉴别方法
知道了内存颗粒编码主要数位的含义,拿到一个内存条后就非常容易计算出它的容量。例如一条三星 ddr 内存,使用 16 片 samsungk4h280838b-tcb0 颗粒封装。颗粒编号第 4、5 位“28”代表该颗粒是 128mbits,第 6、7 位“08”代表该颗粒是 8 位数据带宽,这样我们可以计算出该内存条的容量是 128mbits(兆数位)×16 片/8bits=256mb(兆字节)。
注:“bit”为“数位”,“b”即字节“byte”,一个字节为 8 位则计算时除以 8。关于内存容量的计算,文中所举的例子中有两种情况:一种是非 ecc 内存,每 8 片 8 位数据宽度的颗粒就可以组成一条内存;另一种 ecc 内存,在每 64 位数据之后,还增加了 8 位的 ecc 校验码。通过校验码,可以检测出内存数据中的两位错误,纠正一位错误。所以在实际计算容量的过程中,不计算校验位,具有 ecc 功能的 18 片颗粒的内存条实际容量按 16 乘。在购买时也可以据此判定 18 片或者 9 片内存颗粒贴片的内存条是 ecc 内存。
